报告派研读:2025-2029年电子行业深度报告
摘要: 在人工智能(AI)基础设施(AI Infra)快速升级的背景下,算力需求从“训练”向“推理”转移,推动云厂商资本开支大幅增长。根据报告,2025年北美四大云厂商(Amazon、Meta、Microsoft、Google)资本开支预计达3,496 ...
| 在人工智能(AI)基础设施(AI Infra)快速升级的背景下,算力需求从“训练”向“推理”转移,推动云厂商资本开支大幅增长。 根据报告,2025年北美四大云厂商(Amazon、Meta、Microsoft、Google)资本开支预计达3,496亿美元,同比增长53%,2026年将进一步增至4,243亿美元。 国内阿里和腾讯未来三年资本开支也分别高达3,800亿元和3,500亿元。 这一趋势直接驱动AI服务器、高速网络设备等硬件需求激增,进而对支撑其性能的核心材料提出更高要求。 AI PCB(印制电路板)成为本轮升级的关键增量环节。 随着GPU单芯片算力提升与机柜级互联带宽增强,AI服务器PCB正朝着高多层(20~40层以上)、小线宽/线距(≤40μm)方向发展。 英伟达Blackwell、Rubin系列服务器架构的演进,以及有望采用的正交背板(Midplane)和CoWoP(Chip-on-Wafer-on-PCB)封装技术,都对PCB的信号完整性、散热和制造精度提出了前所未有的挑战。 因此,低介电常数(Low-Dk)和低介电损耗(Low-Df)成为衡量AI PCB性能的核心指标。 在此背景下,构成覆铜板(CCL)的三大核心原材料——电子布、铜箔和树脂,共同构筑了AI PCB介电性能的核心壁垒,并迎来技术迭代的“从0到1”关键节点。 首先,在电子布领域,传统E玻纤已无法满足高频高速需求,以石英纤维布为代表的高性能材料脱颖而出。 石英纤维在1MHz下的Df值仅为0.0001,热膨胀系数(CTE)为0.54ppm/℃,性能远超其他品类。 报告预测,英伟达Rubin服务器的CPX板、中介板(Midplane)及正交背板将采用M9级别的石英纤维布解决方案。 尽管目前全球低介电电子布产能集中于日东纺等少数国际厂商,但2026年供需缺口显现,为中国大陆企业如菲利华、中材科技提供了切入高端供应链的历史机遇。 其次,在铜箔方面,HVLP(高速超低轮廓)铜箔成为主流趋势。 其表面粗糙度Rz≤1.5μm,能有效降低“趋肤效应”带来的高频信号损耗。 当前市场正从HVLP2/3向HVLP4/5升级,日本三井金属、古河电工等是主要供应商。 预计2026年起,NVIDIA Rubin、AMD MI450等新一代产品将全面采用HVLP4方案,松下M9 CCL则可能匹配HVLP5,这为德福科技、隆扬电子等国产铜箔企业带来巨大增长空间。 最后,在树脂领域,传统的环氧树脂因极性基团多、介电损耗高而逐渐被替代。 碳氢树脂(PCH)和聚四氟乙烯树脂(PTFE)凭借优异的介电性能(Dk<3.0, Df<0.001)成为下一代树脂的重要分支。 它们被用于制备M8/M9级别的高频高速覆铜板,以满足56Gbps乃至更高速率的传输需求。 东材科技、圣泉集团等企业在该领域积极布局,其研发的M9级别树脂已通过一线客户验证并实现批量供货。 市场规模方面,受益于HDI板和18层及以上高多层板的需求拉动,预计2025年和2029年全球对应的CCL原材料市场规模将分别达到30.98亿美元和38.91亿美元。 其中,电子布、铜箔、树脂市场规模均将实现稳步增长。 特别是随着英伟达Rubin GPU预计在2026年10月量产,上游供应链有望在2026年上半年开启备货潮,相关材料需求将迎来快速增长期。 投资建议上,报告重点关注三条主线:1)石英纤维布和低介电电子布领域的菲利华、中材科技;2)HVLP铜箔领域的德福科技、隆扬电子;3)高频高速树脂领域的东材科技、圣泉集团。 然而,风险也不容忽视,包括AI市场需求过热引发泡沫、远期供给端产能过剩导致价格下滑,以及新材料新技术变革可能导致现有产品被淘汰。 综上所述,AI Infra的升级浪潮正引发一场深刻的材料革命。 电子布、铜箔、树脂作为决定AI PCB性能上限的“铁三角”,其技术突破与国产化进程不仅关乎产业链安全,更是中国在全球算力竞争中占据有利地位的关键所在。 这场由底层材料驱动的变革,正在重塑电子行业的价值版图。 本文由【报告派】研读,输出观点仅作为行业分析! 原文标题:原文标题:2025-12-23-中银证券-中银证券-电子行业:AI Infra升级浪潮中的材料革命,电子布、铜箔、树脂构筑AI PCB介电性能核心壁垒 发布时间:2025年 报告出品方:中银证券 文档页数:68页
精品报告来源:报告派 |
推荐文章

2
2025年云计算行业应用场景报告
资讯
77人已阅读

3
2025年文科生AI编程研究报告
资讯
79人已阅读

4
2025年人工智能与进攻性安全研究报告
资讯
82人已阅读

5
2025年数据库行业技术趋势报告
资讯
78人已阅读

6
2025年生成式人工智能商业价值报告
资讯
75人已阅读

7
2025年体育领域政策汇编报告
资讯
75人已阅读

8
2025年大型央国企“十五五”战略规划编制实
资讯
97人已阅读

9
2025年电子元件供应链研究报告
资讯
93人已阅读

10
2024年Web3及金融科技研究报告
资讯
69人已阅读
数据图表

2
2011-2031 年全球海上风电装机量(含预测)
行业数据
1716人已阅读

3
2015-2025年 全光伏装机预测(单位:GW)
市场规模
1949人已阅读

4
2020-2025年 全球胶膜需求量及市场规模预测
市场规模
1862人已阅读

5
2022-2026年 光伏银浆市场空间有望快速增长
市场规模
1932人已阅读
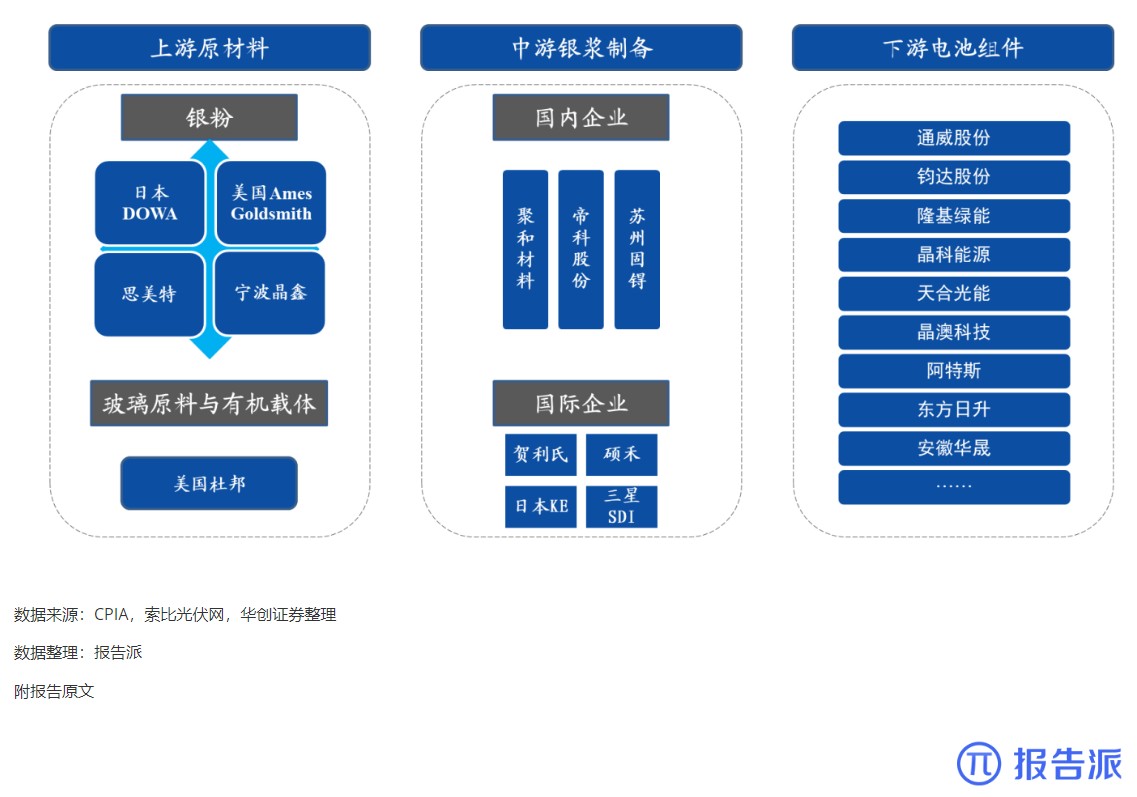
6
光伏银浆产业链相对简单
技术工艺
1828人已阅读

7
2020-2025年 我国湿电子化学品需求预测(万
市场规模
1813人已阅读

8
2020-2025年 全球湿电子化学品需求量(万吨
市场规模
1935人已阅读
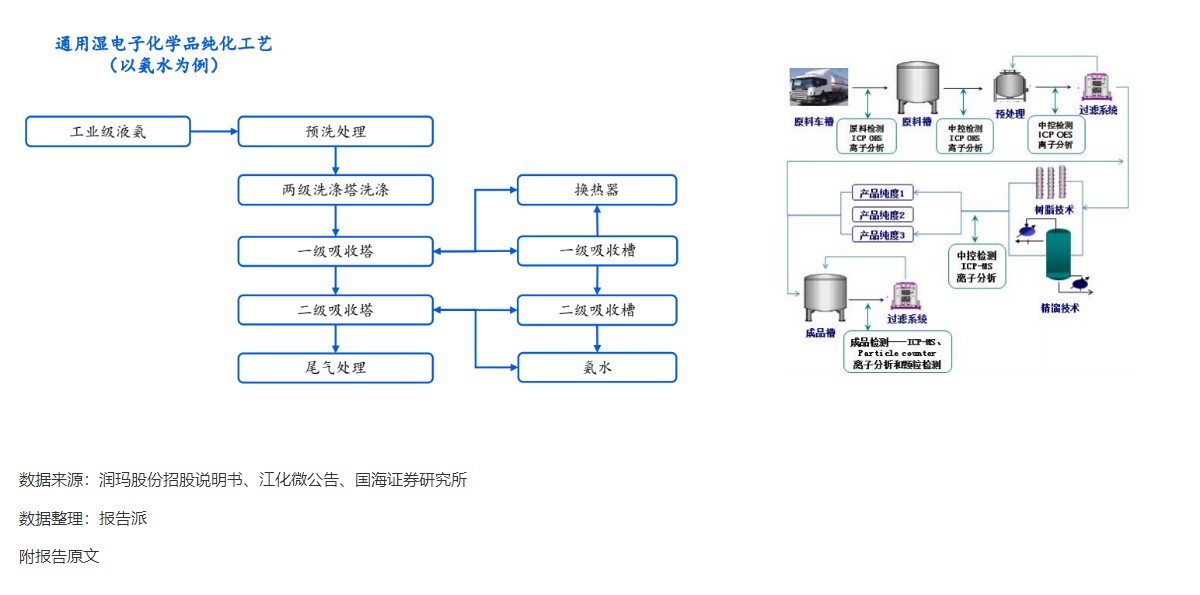
9
通用湿电子化学品纯化工艺
技术工艺
1674人已阅读

10
湿电子化学品上下游产业链基本情况
技术工艺
1944人已阅读
热门数据
1
2024年1—2月份规模以上工业增加值增长7.0%
2024-03-22
2
截至2023年底我国累计建成充电基础设施859.
2024-03-22
3
2024年3月21日人民币 NDF 远期合约汇兑美元
2024-03-21
4
2024年1—2月份能源生产情况
2024-03-21
5
2024年2月银行结售汇和银行代客涉外收付款
2024-03-21
6
2024年3月韩国方便面出口2.3万吨,同比增加
2024-03-21













